
TSMC освоит выпуск интегральных микросхем с трёхмерной компоновкой в 2021 году
Поиском новых компоновочных решений в последние годы занимаются все разработчики центральных и графических процессоров. Компания AMD продемонстрировала так называемые «чиплеты», из которых сформированы процессоры с архитектурой Zen 2: на одной подложке соседствуют несколько 7-нм кристаллов и один 14-нм кристалл с логикой ввода-вывода и контроллерами памяти. Компания Intel об интеграции разнородных компонентов на одной подложке говорит давно и долго и даже пошла на сотрудничество с AMD в рамках создания процессоров Kaby Lake-G, чтобы продемонстрировать другим клиентам жизнеспособность данной идеи. Наконец, даже NVIDIA, чей генеральный директор гордится способностью инженеров создавать невероятные по площади монолитные кристаллы, на уровне экспериментальных разработок и научных концепций возможность использования многокристальной компоновки тоже рассматривает.

Ещё в заранее подготовленной части доклада на квартальной отчётной конференции глава TSMC Си Си Вэй (C.C. Wei) подчеркнул, что компания ведёт разработку трёхмерных компоновочных решений в тесном взаимодействии с «несколькими лидерами отрасли», и массовое производство подобных изделий будет развёрнуто в 2021 году. Спрос на новые компоновочные подходы демонстрируют клиенты не только в сфере высокопроизводительных решений, но и разработчики компонентов для смартфонов, а также представители автомобильной отрасли. Глава TSMC убеждён, что с годами услуги по трёхмерной упаковке продуктов будут приносить компании всё больше выручки.
Многие клиенты TSMC, по словам Си Си Вэя, в будущем возьмут курс на интеграцию разнородных компонентов. Однако прежде чем такой дизайн станет жизнеспособным, необходимо разработать эффективный интерфейс для обмена данными между разнородными кристаллами. Он должен обладать высокой пропускной способностью, низким энергопотреблением и низкими потерями. В ближайшее время экспансия трёхмерных методов компоновки на конвейере TSMC будет происходить умеренными темпами, резюмировал генеральный директор компании.
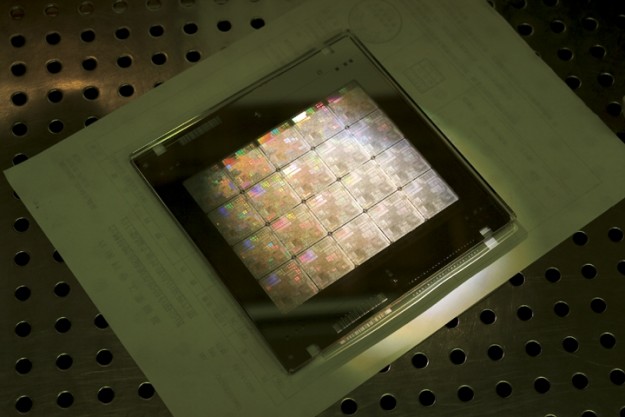
Представители Intel недавно заявили в интервью, что одной из главных проблем трёхмерной компоновки является отвод тепла. Инновационные подходы к охлаждению будущих процессоров тоже рассматриваются, и здесь Intel готовы помогать партнёры. Более десяти лет назад IBM предложила использовать систему микроканалов для жидкостного охлаждения центральных процессоров, с тех пор компания далеко продвинулась в использовании жидкостных систем охлаждения в серверном сегменте. Тепловые трубки в системах охлаждения смартфонов тоже начали использоваться лет шесть назад, поэтому даже самые консервативные клиенты готовы пробовать новое, когда застой начинает
Возвращаясь к TSMC, уместно будет добавить, что на следующей неделе компания проведёт в Калифорнии мероприятие, на котором расскажет о ситуации с освоением 5-нм и 7-нм техпроцессов, а также передовых методах монтажа полупроводниковых изделий в корпус. Трёхмерная разновидность тоже включена в повестку дня мероприятия.
Джерело: 3DNews.ru
Обговорення новини
Попередні новини
 5G-модем и восемь ядер Kryo 400 Series: рассекречен процессор Snapdragon 73500:22 21.04.2019
5G-модем и восемь ядер Kryo 400 Series: рассекречен процессор Snapdragon 73500:22 21.04.2019Сетевые источники опубликовали подробные технические характеристики мобильного процессора Qualcomm Snapdragon 735, анонс которого ожидается в конце текущего года. Необходимо сразу оговориться, что обнародованные данные носят неофициальный характер, а поэтому их достоверность остаётся под вопросом.
 Илон Маск: к концу 2019 года автопилот Tesla превзойдёт умения водителя15:09 19.04.2019
Илон Маск: к концу 2019 года автопилот Tesla превзойдёт умения водителя15:09 19.04.2019Исполнительный директор Tesla, SpaceX и Boring Company Илон Маск (Elon Musk) славится своими преждевременными громкими заявлениями. Недавно в беседе с исследователем из Массачусетского технологического института Лексом Фридманом (Lex Fridman) он заявил, что к концу 2019 года автопилот Tesla будет превосходить способности людей по управлению автомобилем.
 Президент Xiaomi заверил, что компания усердно работает над массовым производством продуктов со 100-ваттной зарядкой09:43 17.04.2019
Президент Xiaomi заверил, что компания усердно работает над массовым производством продуктов со 100-ваттной зарядкой09:43 17.04.2019В марте этого года Xiaomi анонсировала технологию быстрой зарядки Super Charge Turbo, которая имеет максимальную мощность 100 Вт. Компания заявила, что данная технология позволит заряжать смартфон с аккумулятором емкостью 4000 мАч до 100% за 17 минут, как показано в следующем ролике.

